英特尔:EMIB 封装优于传统 2.5D 芯片,成本更低、设计更简单英特尔EMIB2.5D 封装台积电
英特尔详解其EMIB封装技术,强调相比传统2.5D方案,EMIB在成本、设计复杂度和系统灵活性上更具优势,已用于Ponte Vecchio等多款产品,并成为其代工业务核心能力之一。未来与台积电的竞争或将加剧。#芯片封装##英特尔##半导体技术#
IT之家,2026-01-18 14:04:38
1 月 18 日消息,英特尔本周四对其 EMIB(Embedded Multi-die Interconnect Bridge,嵌入式多芯片互连桥)技术与传统 2.5D 封装方案进行了对比,强调 EMIB 在成本、设计复杂度和系统灵活性等方面具备明显优势,更适合用于下一代先进封装芯片的设计与扩展。

英特尔表示,EMIB 已被广泛应用于其多款产品中,包括 Ponte Vecchio、Sapphire Rapids、Granite Rapids、Sierra Forest,以及即将推出的 Clearwater Forest 系列。
未来,无论是英特尔自研芯片还是面向代工客户的产品,先进封装都将成为核心能力之一。这些面向数据中心的高端芯片通常采用大规模封装,集成多个芯粒(Chiplet),并通过 EMIB 及其他英特尔自有封装技术进行互连。
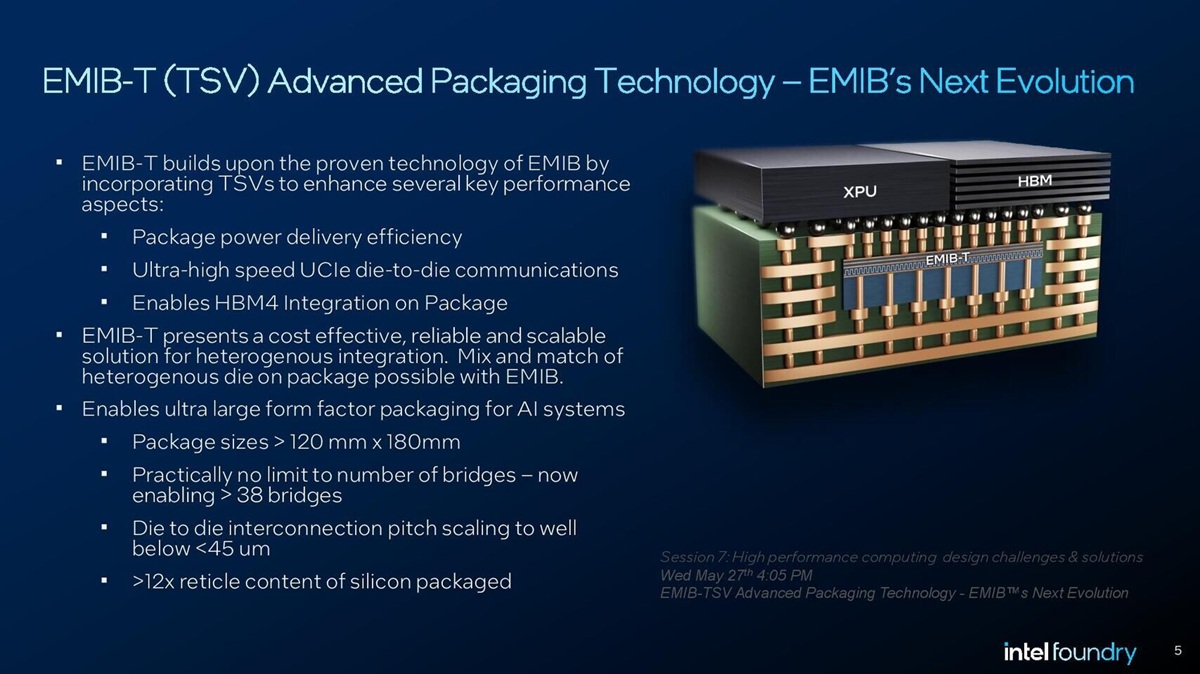
作为对比,目前行业竞争对手(如台积电)的先进封装方案主要基于 2.5D 和 3D 技术。在 2.5D 封装中,多个芯粒通过一整块硅中介层进行连接,芯粒之间的信号传输依赖硅中介层内的 TSV(硅通孔)。
英特尔指出,这种方案需要额外使用大量仅用于布线的硅材料,随着芯片尺寸增大,封装成本和设计复杂度显著上升,同时 TSV 也会对良率带来不利影响。

英特尔认为,2.5D 封装在芯片尺寸和芯粒组合方式上存在一定限制,不利于灵活地混合不同类型的计算芯粒和存储芯粒,限制了系统级设计的自由度。
相比之下,EMIB 通过将小型硅桥直接嵌入封装基板,在需要互连的芯粒之间提供高速连接,无需使用整块硅中介层。英特尔强调,这种方式不仅降低了材料和制造成本,还能根据需求灵活放置互连桥,从而提升封装设计的可扩展性。

英特尔目前将 EMIB 分为两种主要形态。
其一是 EMIB 2.5D,适用于逻辑芯片之间或逻辑芯片与 HBM 之间的连接,并已于 2017 年进入量产。EMIB-M 在硅桥中集成 MIM 电容,EMIB-T 则在硅桥中引入 TSV,以便更好地支持不同封装方案的 IP 集成。
其二是 EMIB 3.5D,该方案将 EMIB 与 Foveros 3D 封装结合,用于构建更加复杂的异构系统。例如,英特尔数据中心 GPU Max 系列 SoC 便采用了 EMIB 3.5D 方案,集成了 47 个有效芯粒、跨越 5 种制程节点,总晶体管数量超 1000 亿。

英特尔总结了 EMIB 的三大核心优势:封装良率处于正常范围、具备显著的成本节约空间,以及整体设计流程相对简单。
英特尔认为,随着其加速推进代工业务,并布局包括 14A 在内的先进制程节点,EMIB 与 Foveros 等先进封装技术将成为提升竞争力的关键因素,也有望加剧与台积电在高端芯片制造领域的竞争。
相关阅读: